[테크월드뉴스=서유덕 기자] 어플라이드 머티어리얼즈(AMAT)가 이종 칩 설계·결합을 위한 새로운 기술과 역량을 16일 발표했다. AMAT는 패키징·대면적(large-area) 기판 분야 업체들과 협업함으로써 솔루션 공급 속도와 PPACt(전력·성능·크기·비용·출시소요기간)를 개선한다.
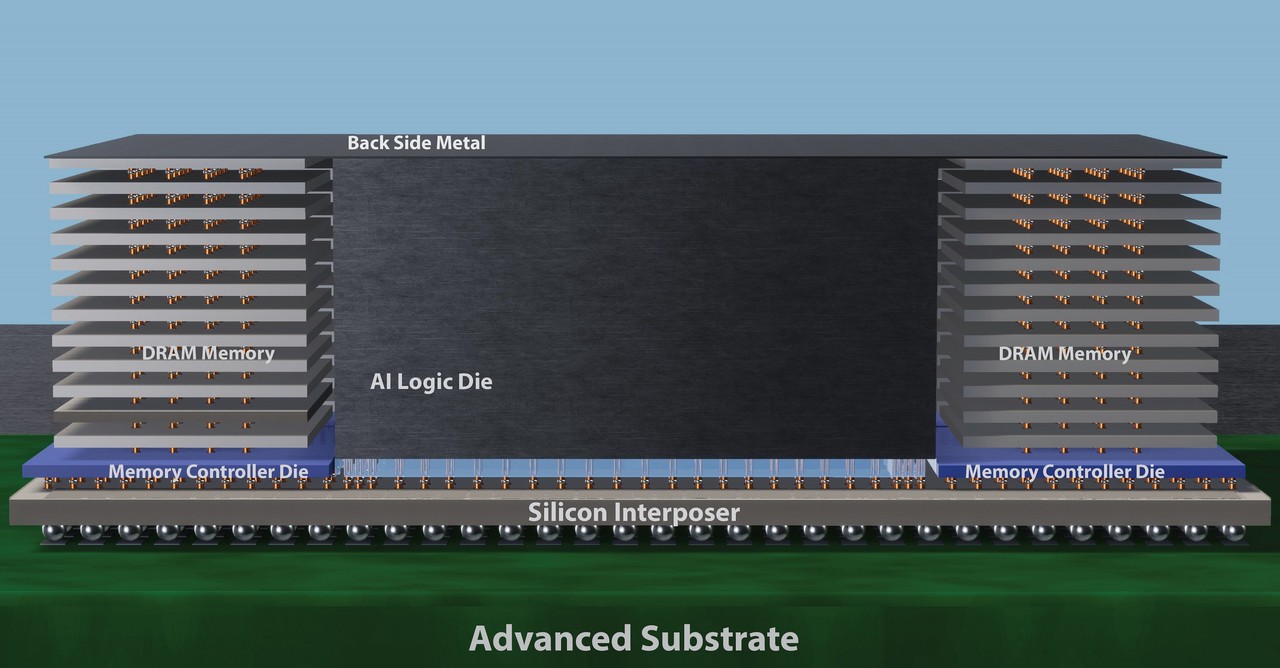
AMAT가 발표한 ▲다이 투 웨이퍼(die-to-wafer) 하이브리드 본딩 ▲웨이퍼 투 웨이퍼 본딩 ▲첨단 기판 기술은 이종 결합(heterogeneous integration)을 위한 새로운 패키징 기술이다. 이종 결합은 다양한 기술이 적용된 서로 다른 기능과 크기의 반도체를 하나의 패키지로 제작해 반도체 기업에 유연성을 제공한다.
AMAT는 식각, PVD(물리기상증착), CVD(화학기상증착), 전기도금, 표면처리, 가열냉각 등 영역을 망라하는 제품을 공급한다. 싱가포르에 위치한 AMAT 첨단 패키징 개발 센터는 첨단 범프(bump), 마이크로 범프, 미세라인 RDL(재배선층), TSV(실리콘관통전극), 하이브리드 본딩 등 이종 결합의 근간이 되는 포트폴리오를 보유하고 있다.
다이 투 웨이퍼 하이브리드 본딩 가속화
다이 투 웨이퍼 하이브리드 본딩은 구리와 구리의 직접 결선으로 입·출력(I/O) 밀도를 높이고 칩렛 간 배선 길이를 줄여 성능, 전력, 비용을 향상시킨다. AMAT는 보다 빠르게 기술을 개발하기 위해 첨단 소프트웨어 모델링과 시뮬레이션을 싱가포르 패키징 개발 센터에 도입했다. 이 같은 역량을 통해, AMAT는 하드웨어 개발 전에 재료 선택, 패키징 아키텍처 등 여러 요인을 미리 평가하고 최적화해 학습주기와 시장 출시 기간을 단축한다.
한편 이 기술은 작년 10월 발표한 합의에 따라 AMAT와 BE 세미컨덕터 인더스트리(Besi)가 공동 개발했다. 뤼르트 붐즈마(Ruurd Boomsma) Besi 최고기술책임자(CTO)는 “AMAT와 공동 개발 프로그램을 진행하면서 고객이 웨이퍼 레벨 생산 환경에서 복잡한 하이브리드 본딩 공정을 활용하는 데 필요한 공동 최적화 솔루션 관련 이해도가 높아졌다”며 “Besi와 AMAT는 싱가포르 하이브리드 본딩 CoE(Center of Excellence)에서 고객의 재료를 가공하고 첨단 이종 결합 기술을 개발함에 있어 매우 짧은 기간 내 탁월한 성과를 거뒀다”고 말했다.
웨이퍼 투 웨이퍼 하이브리드 본딩 공동 최적화 솔루션 개발
웨이퍼 투 웨이퍼 본딩 기술을 활용하면 첫번째 웨이퍼에는 반도체 구조를, 두번째 웨이퍼에는 다른 요소를 구현한 다음 두 웨이퍼를 접합해 완전한 소자를 생성할 수 있다. 고도의 성능과 수율 달성을 위해서는 웨이퍼를 접합하는 과정의 정밀한 균일도와 정렬도 관련 전공정 단계의 품질이 중요하다.
AMAT는 웨이퍼 투 웨이퍼 본딩에 대한 공동 최적화 솔루션 개발을 위해 EV그룹과 공동 개발 협약을 체결했다. 이번 협업으로 증착, 평탄화, 임플란트, 계측, 검수 등 AMAT의 반도체 공정 전문지식과 EV그룹의 웨이퍼 접합, 전처리, 활성화는 물론 정렬, 본드 오버레이 계측 분야 리더십 간 시너지가 예상된다.
토마스 어만(Dr. Thomas Uhrmann) EV그룹 사업개발 디렉터는 “반도체 혁신에서 3D 접합과 공학 재료의 중요도는 갈수록 증가하고 하이브리드 웨이퍼 본딩 수요도 높아지면서, 웨이퍼 투 웨이퍼 본딩 같은 중요한 공정을 새로운 애플리케이션에 최적화하기 위해서는 공정 체인의 전후 과정의 통합에 대한 심층적 이해가 요구된다”며 “AMAT와 협업을 통해 공정 장비 기업들은 데이터를 상호 공유하고 각자 전문 분야를 학습하며 솔루션을 공동 최적화하고, 새로 발생하는 제조 문제를 원활하게 해결할 수 있을 것”이라고 설명했다.
대형화·첨단화된 기판으로 PPACt 혜택 제공
반도체 제조사가 이전보다 훨씬 많은 수의 반도체를 정교한 2.5D/3D 패키지 설계에 적용함에 따라 첨단화된 기판의 필요성이 높아졌다. 상호결선 밀도가 높은 대형 크기의 패키지 구현을 위해 AMAT는 최근 인수한 탱고 시스템(Tango Systems)의 첨단 패널 레벨 가공 기술을 사용한다. 패널 크기가 500×500㎟ 또는 그 이상인 기판은 웨이퍼 크기 형태와 비교했을 때 더 많은 패키지를 수용해 전력, 성능, 크기는 물론 비용 혜택도 제공한다.
대형 패널을 고객이 채택함에 따라 AMAT는 자사 디스플레이 그룹을 통해 증착, 전자빔, 테스팅, SEM 리뷰, 계측, 결함 분석용 집속 이온빔 등 대면적 재료 공학 기술을 제공한다.
그래도 삭제하시겠습니까?




